2025年芯片测试与可靠性技术五大趋势
2025年芯片测试与可靠性技术五大趋势预测,涵盖AI辅助、数字孪生、Chiplet测试、云化ATE和绿色方向,提供行业前瞻洞见。

2025年芯片测试与可靠性技术五大趋势预测,涵盖AI辅助、数字孪生、Chiplet测试、云化ATE和绿色方向,提供行业前瞻洞见。

详解AEC-Q200标准对车规无源元件(电阻、电容、电感)的可靠性测试要求,涵盖温度循环、耐焊热、湿度偏压等关键项目及验收标准,助力元器件厂商高效通过车规认证。关键词:AEC-Q200, 无源元件, 车规阻容感。

全面解析AEC-Q100 Rev-G标准要求,详解HTOL、温度循环、ESD等关键测试项目,梳理从预测试、正式认证到获取报告的完整流程与周期,助力芯片企业高效通过车规认证。关键词:AEC-Q100, 车规芯片, 可靠性测试。
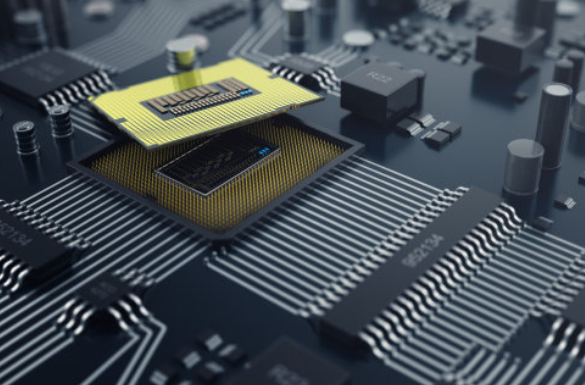
详解气候老化测试在芯片可靠性验证中的作用,涵盖光照、雨水、温度循环等应力对封装材料的老化影响,介绍IEC、JEDEC等标准方法及典型失效模式。关键词:气候老化, 可靠性测试。

详解被动电压对比(PVC)技术在芯片开路与高阻故障定位中的应用,介绍其无源、非破坏性检测原理、操作流程及与其他定位方法的协同策略。关键词:PVC, 芯片失效分析。

详解MEMS传感器在可靠性测试中的特殊需求,涵盖温漂、迟滞、长期稳定性及环境干扰等关键指标的测试方案,助力汽车电子与工业应用通过严苛认证。关键词:MEMS传感器, 可靠性测试。

深入解析热阻在芯片失效分析中的关键作用,介绍主流测量方法、测试流程及其对功率器件可靠性的影响,帮助工程师通过热性能评估精准定位失效根因。关键词:热阻测试, 芯片失效分析, 功率芯片。

深入解析芯片在潮湿环境中因电化学迁移(ECM)导致短路的失效机理,涵盖金属离子溶解、枝晶生长过程、典型形貌特征及系统性预防策略,适用于封装可靠性与失效分析工程师。关键词:电化学迁移, 芯片失效分析。

详解车规级电源管理芯片(PMIC)在AEC-Q100框架下的核心可靠性测试项目,包括高温工作寿命(HTOL)、负载瞬态响应、短路保护验证等关键指标,助力汽车电子设计通过严苛认证。关键词:车规PMIC, 可靠性测试。

深入剖析芯片电迁移(Electromigration)的物理机制、Black’s方程加速模型、寿命预测方法及设计规避策略,助力IC工程师提升互连可靠性。适用于先进工艺节点下的可靠性设计与失效分析。关键词:电迁移, 芯片失效分析, 可靠性寿命。

深入解析芯片电过载(EOS)与静电放电(ESD)失效的本质差异,从波形特征、损伤形貌、测试条件三大维度进行对比,提供实用识别方法,避免工程误判。适用于IC设计、可靠性测试与失效分析工程师。关键词:EOS, ESD, 芯片失效分析。

深入解析芯片失效分析中常见的电学短路问题,涵盖金属互连缺陷、工艺污染、ESD损伤等成因,介绍IV曲线测试、EMMI、FIB-SEM等先进检测方法,并提供从设计到封装的系统性预防策略。关键词:芯片失效分析、电学短路、失效检测。
注意:每日仅限20个名额

扫码咨询
广州分公司
地址:广州市黄埔区云埔街源祥路96号弘大商贸创意园5号楼605房
深圳分公司
地址:深圳市坪山区碧岭街道碧岭社区坪山金碧路543号忠诚科技大厦801B
上海分公司
地址:上海市奉贤区星火开发区莲塘路251号8幢
芜湖分公司
地址:安徽省芜湖市镜湖区范罗山街道黄山中路金鼎大厦1411